原子拡散接合 (ADB) 装置 BC7300

BC7300原子拡散接合装置は、基板搬送~成膜~接合~回収までを全自動オペレーションにて真空一貫処理する∅200 mm、∅300 mmウェハー対応装置です。
接合に用いる薄膜の種類と膜厚を最適化することで、ウェハーの材質によらず、常温、無加圧で原子レベルでの接合が可能となります。
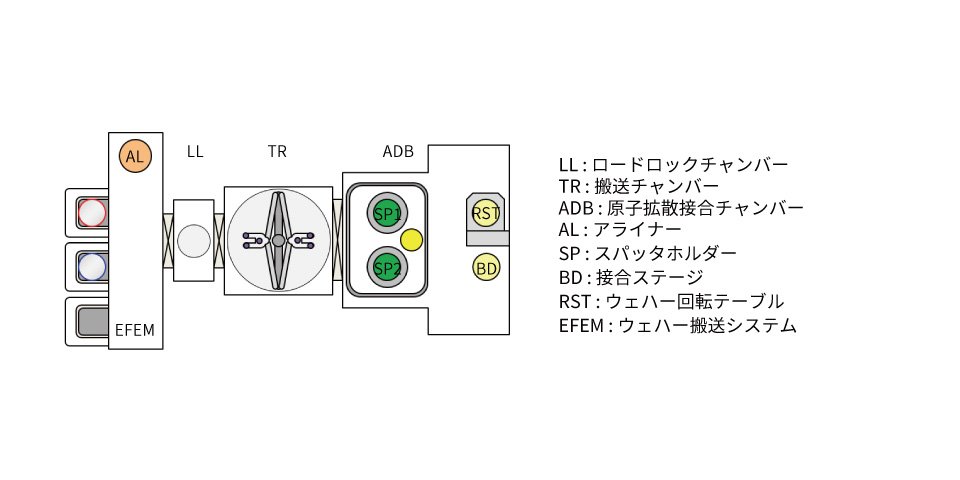
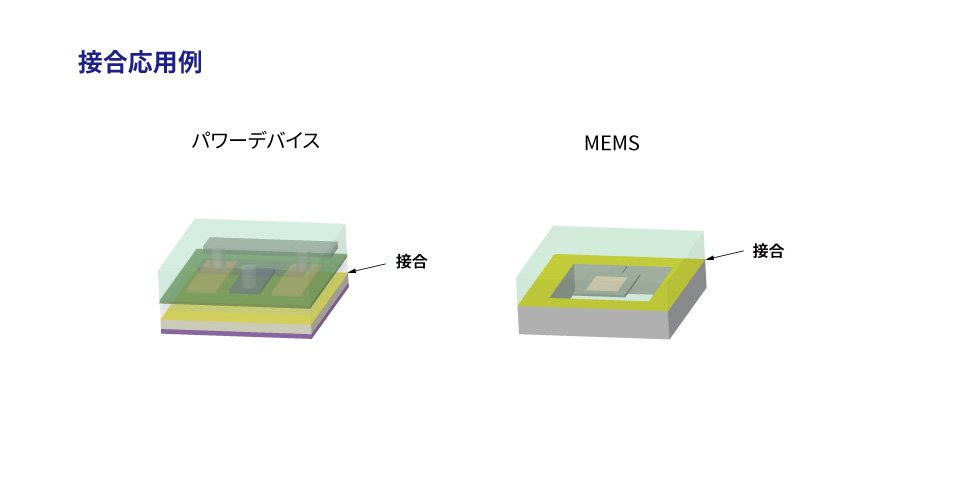
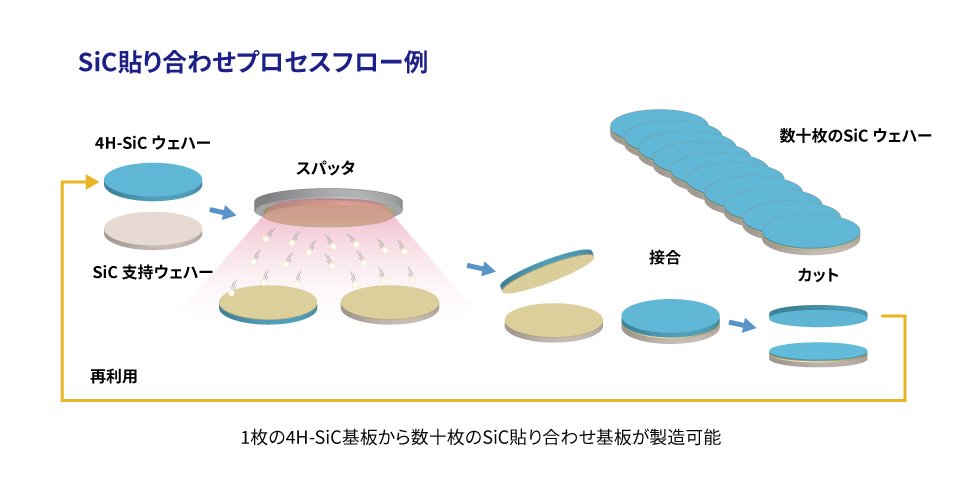
製品情報
常温で接合
薄膜の表面における原子拡散で接合するため、熱を加える必要がありません。
無加圧で接合
接合面に形成した薄膜の表面エネルギーを利用するため、加圧する必要がありません。
強固な接合
原子レベルで結合しているため、接合強度が高く、信頼性、耐久性に優れています。
異種材料の接合
常温プロセスのため、熱に弱いデバイスの接合や熱膨張率の異なる異種材料の接合を可能にします。
接合する2枚のウェハー表面にスパッタリングにて薄膜を形成し、引き続き同一超高真空中で成膜面を相互に接触させ、薄膜表面における原子拡散を利用して接合します。
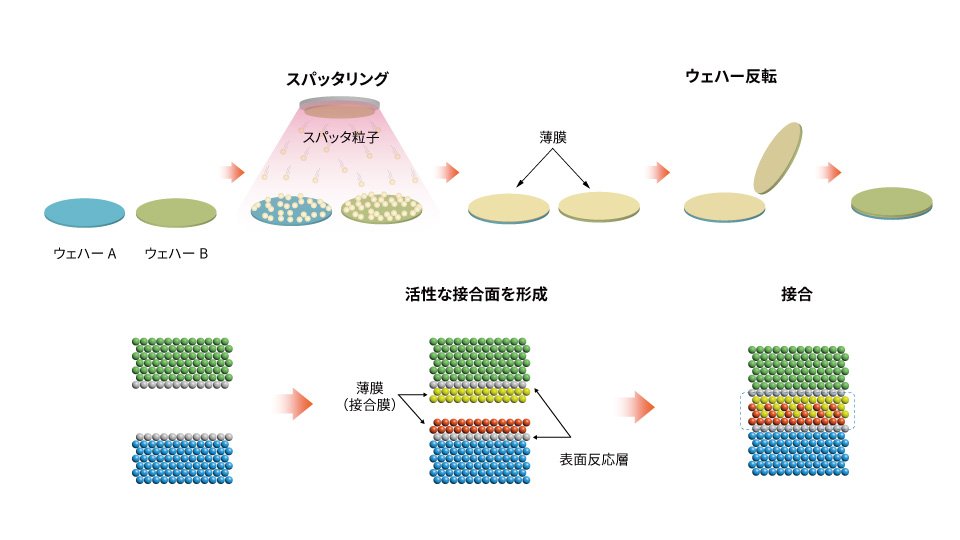
- 高密度実装
- LED
- パワーデバイス
SiC貼り合わせ基板など、化合物基板の接合 - MEMS*1
Si基板とガラス基板との接合
※その他ご希望の材料に関しては、お問い合わせください。
*1 MEMS:Micro Electro Mechanical Systems
当社の接合装置は∅200 mm、∅300 mmウェハーで以下の材料の接合ができます。
接合材料としてスパッタ成膜する材料例
- チタン (Ti)
- シリコン (Si)
- アルミナ (Al2O3)
- 窒化アルミ (AlN)
※ご用途により最適な接合材料をご提案させて戴きます。
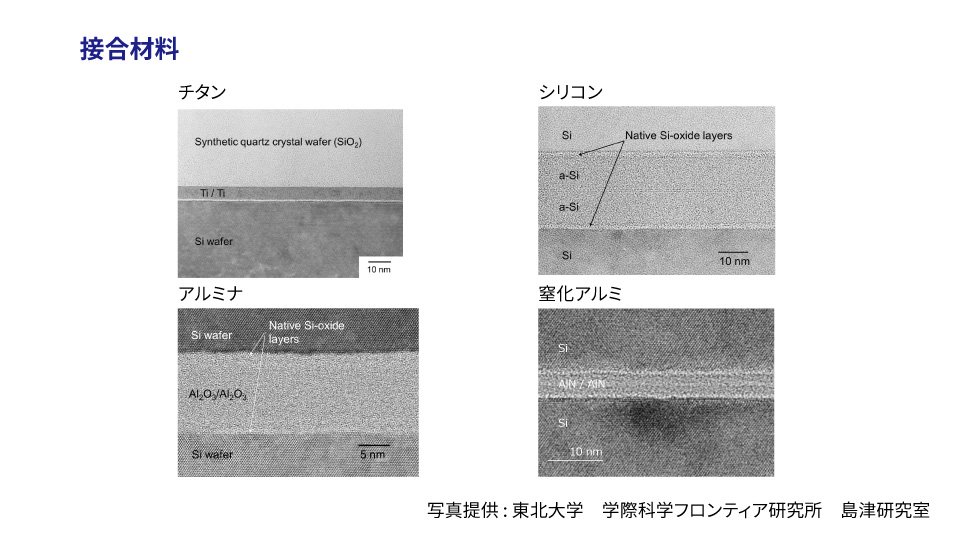
- 装置構成:クラスター式
- 対応基板サイズ:∅200 mm, ∅300 mm
- 主排気系:ターボ分子ポンプ
- 電力:3φ AC 200 V ±10%, 225 A, 50/60 Hz (D種接地)
- 冷却水:21 〜 33 L/min, 0.2 〜 0.3 MPa, 15 〜 30℃
- 圧縮空気:0.5 〜 0.8 MPa
- プロセスガス:0.15 〜 0.4 MPa
- 質量:6,730 kg (装置本体)
- 設置面積:W4,000 mm × D7,100 mm